

通过磨轮对晶圆背面进行研磨以达到封装需要的厚度
· 8寸,12寸的晶圆加工能力
· 研磨厚度能达到30um
· 研磨厚度误差±5um

通过激光高温灼烧切割晶圆表面的金属层来降低晶圆侧崩
· 开槽宽度范围5~35um
· 开槽深度15~20um
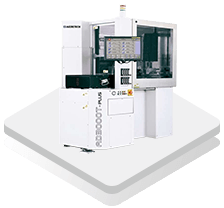
品圆切割是沿着切割道用刀片将品圆上的一颗颗芯片切割分离
· 切割道最小能达到40um
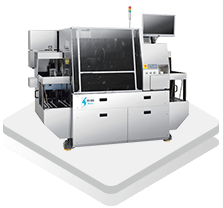
把芯片贴在基板上,并通过DAF膜固定
· 装片精度±5um
· 双焊头,提升效率
· 贴装作业30um厚度的芯片,可以堆叠2-16层晶圆
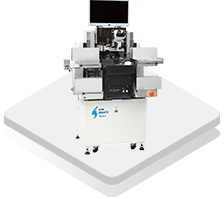
利用高纯度的金线或合金线把芯片的焊盘与基板的引脚连接起来
· 最小可作业直径0.6mil的金线
· 自动聚焦,可以作业叠层产品

用树脂把完成焊线的芯片密封起来,保护芯片及焊线,避免受损、污染和氧化
· 高精密设备可生产2-16层堆叠
· 减少超薄芯片的破裂,保证产品品质的稳定性

通过激光在产品表面镭射上商标及产品信息
· 深度误差±3um
· 一键切换产品类型

将固定规格的锡球焊接在已经塑封的基板背面的焊盘上
· 锡球最小直径0.25mm
· 最小锡球间距0.4mm

用刀片将已经封装好的芯片从基板上独立分开
· 切割宽度0.2~0.3mm
· 切割偏差±3um
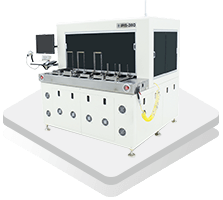
通过光学镜头对产品外观进行检测,同时设备区分外观类型
· 锡球外观检测
· 字符内容检测

用树脂把完成焊线的芯片密封起来,保护芯片及焊线,避免受损、污染和氧化
· 高精密设备可生产2-16层堆叠
· 粉末状树脂最大程度保护芯片和线路

基本性能测试
性能测试
IOPS测试
Latency测试
客户场景模拟测试
Raid测试

HAST HTOL LTOL
TC ELFT EDR
读干扰测试
数据保持能力测试
寿命测试

针对不同芯片组进行兼容性测试
针对不同系统如Window/Linux/Android及不同版本进行兼容性测试

OS/Leakage测试
静/动态功耗测试
AC参数测试
DC参数测试

参考JEDEC对应规范及对应协议规范进行完整协议测试

SI信号完整性测试
PI电源完整性测试

压力测试 掉电测试
热插拔测试 跌落测试
存储温度上下限测试
温度偏压四角测试
温度循环测试 温度冲击测试
工作温度测试 高低温读写测试
振动测试 冲击测试